アッシング装置
Model:NA
次世代ウェーハプロセスから実装工程まで幅広いプロセス向けの、ウェーハとパネル対応の2タイプを提供するアッシング装置です。
ウェーハ対応モデルは、次世代ウェーハプロセスからウェーハレベル実装工程まで幅広いプロセスに対応できるウェーハサイズフリー設計で、半導体実装工程に採用率No.1の装置で、パネル対応モデルは、最大600mm□に対応し、大型パネルでも均一にDescum処理やTiエッチングを行うことができます。
特長
-
Model: NA-8000, 1300
- ダメージフリーなイオンインプラント剥離プロセスおよびポリマー除去プロセスを実現可能
- F系ガス添加プロセスに最適なチャンバー構成により、パーティクルフリー対応が可能。これにより、ノーマルPR、イオンインプラント剥離、有機膜剥離(PI、DFRなど)、酸化膜エッチングなど、幅広いプロセスに対応可能
- シンプルな装置構成を採用し、優れたメンテナンス性と高い信頼性、さらに低コストを実現
- チャンバー構成の選択肢(μ波、RIE、μ波+RIE)により、プロセスに応じた最適な設定が可能
- レシピ設定で簡単にウェーハサイズの変更可能
- μ波ダウンフローおよびRFバイアスの選択が可能
- Tiシード層のエッチングやDescum、その他の表面処理プロセスにも対応
- アッシング以外の新しいプロセスとして、表面処理や親水化処理にも対応が可能
Model: NA-1500
用途
- フロントエンドプロセスにおける イオンインプラント剥離プロセス(1 x 1016atoms/cm2以上)やポリマー除去
- CF4添加プロセスが必要なウェハプロセス(電子部品・LED)
- チップサイズパッケージやBUMP工程
- CCDカラーフィルター製造プロセス
- Descum、Desmear
- 表面改質(撥水性→親水化,親水性→撥水化)めっきなどWet工程の前処理,アンダーフィル前処理
- 樹脂系材料のアッシング
- Seed層Tiのエッチング
- SiO2, SiNのエッチング
 |
 |
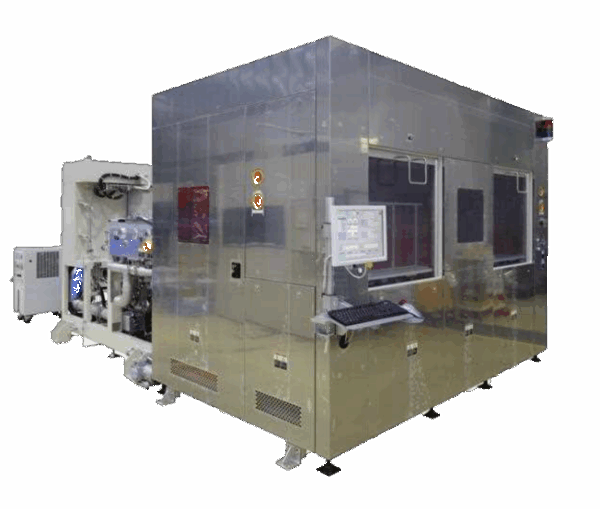 |
| NA-8000 | NA-1300 | NA-1500 |

